「熱」と正しく向き合う:熱設計の基礎理論から評価/計測ノウハウまで(5/8 ページ)
■(2)チップからの放熱量の評価
ICからの放熱には、基板やヒートシンクが寄与することになる。放熱は、放射、対流、伝導といった形で行われる。
これらのうち、放射は放熱の方法として有効なものではないことが多い。しかし、人工衛星の設計では、システムから熱を除去するためのほかの方法が存在しないため、放射が用いられる。宇宙空間では周囲の温度が絶対零度に近い。宇宙空間に対してであれば熱を放出するに十分な温度差があるので、放射を利用することで、電子部品が燃焼するのを避けることができる。
対流は多少複雑である。例えば、市販のヒートシンクは気流による影響を受け、気流が大きい場合には熱抵抗が5倍も改善される(図7)。ファン型のCPU冷却装置をよく見てみると、強制空冷を行うヒートシンクには、薄型のフィンが密に並べられている。製品にファンがない場合には、ICの熱は伝導し、拡散して、装置内の空気に放出される。そして装置全体が加熱されると、熱は周囲の大気へと対流する。仮にその装置が人間のひざの上にあれば、伝導によっても熱が放出される。対流ではケースの材料の熱抵抗も重要となる。プラスチック製のケースの場合、金属製のものよりも、内部から外部環境への熱放出は遅い。
戦闘機は約7万フィート(2万1336m)の上空で稼働する。この高度では大気が非常に薄く、対流による冷却は行えない。このようなシステムには冷却プレートがあり、エチルグリコールの冷却路によってプレートが80℃以上にならないようにしている。そしてすべての部品が金属製のヒートスプレッダに物理的に接触しており、それにより部品が発する熱を基板の縁へと逃がす。基板の縁では、熱伝導性の高いクランピングシステムによってヒートスプレッダがケースの側面に固定されている。ケースの側面では、ケースの下にある冷却プレートへと熱を逃がすようになっている。さらに熱伝導グリースにより、熱をできるだけ冷却プレートに送って、ICの熱ができる限りヒートシンクに移動するようにする。
電気エンジニアの多くは、熱の解析手法として熱抵抗を利用する。熱抵抗Φの単位は「℃/W」である。これに最初のステップで概算した消費電力を乗じるだけで、部品の上昇温度が得られる。ただし、ここにはいくつか注意すべき点がある。
部品のデータシートにおいて、熱抵抗に関する仕様の添え字の部分を見てほしい。チップ(接合部)からケース(パッケージ)への熱抵抗ΦJCは、有効な値ではない。半導体メーカーのIC/パッケージ設計者は、チップからケースに放熱する際のICの温度上昇に関心があるだろうが、実際にはそれ以上の情報が必要である。
データシートで次によく参照するのは、接合部から大気に対する熱抵抗ΦJAだ。この値は、部品がヒートシンクに接続されていない場合や、プリント基板にはんだ付けされていない場合の温度上昇に対応する。米Texas Instruments(TI)社のフェローであるDarvin Edwards氏は、「接合部の温度を予測する際にはΦJAの値は参考にならない」と指摘している。「必要なのは、チップからボードへの熱抵抗であるΦJBと、チップからパッケージへの熱抵抗のΦJCだ」(同氏)という。さらに同氏は、「エンジニアにそれがパッケージの定数ではないことを示すために、われわれはJEDEC(Joint Electron Device Engineering Council)規格に準拠した2枚の基板を用いてΦJAを測定する。1枚は片面基板で、もう1枚は多層基板だ。ΦJBとΦJCのスペックがあれば、ICの温度上昇についてより現実的な評価が行える」とした上で、「基板上にほかのチップがない状態でΦJAが測定されていることを覚えておく必要がある」と指摘する。ICの周りに電源ICなどのように大きな熱を発するチップがあったり、ファンのないプラスチックケースの中に基板が密閉されていたりする場合には、実際の温度上昇はΦJAを用いて算出した値よりも高くなるのだ(図8)。
なお、ほとんどのICでは、プラスチックパッケージの上面から多少の熱伝導がある。とはいえ、エポキシ樹脂(プラスチック)の熱伝導性は0.6〜1W/mK、銅のそれは400W/mKである。つまり、銅はエポキシ樹脂よりも400〜600倍も熱伝導性が高い。熱伝導性ができるだけ高くなるようにプリント基板を設計することが重要である。
基板の放熱を評価するためのより高度な手法もある。National Semiconductor社のオンライン設計ツール「WEBENCH」では、英Flomerics社の熱解析ソフトウエア「Flotherm」を用いて、静止大気中における部品の温度を算出する。この種のシミュレーションを行う際には、ここまでに述べたような一般的な注意事項に気を配らなければならない。例えば、回路にファンや気流がある場合、温度上昇は抑えられる。また、密閉された状態である場合やほかの部品が存在する場合には、温度はさらに上昇する。Flomerics社のソフトウエアでは、有限要素解析手法を用いる*5)。図9に示したのは、同手法を用いて、コンピュータの筐体で発生する熱と気流を解析した結果である。
ほかにも、熱解析に適用できる有限要素解析手法を備えたツールはいくつも存在する。例えば、スウェーデンCOMSOL社の解析手法ではマルチフィジックスを扱える。それにより、温度によって熱伝導性が変化するような部品における熱反応など、複数の偏微分方程式を解くことが可能である。また、TI社のEdwards氏は、「当社では、ΦJBで表した抵抗とDelphiのコンパクトモデル規格という2種類の抽象化手法を用いた熱モデリング機能を提供する」と述べている。Flothermのほかにも、「Icepak」(米FLUENT社)など多くの熱解析ツールでこれらのモデルが用いられている。
脚注
※5…『電磁界解析ツール活用のススメ』(Paul Rako、EDN Japan 2007年4月号 p.51)
Copyright © ITmedia, Inc. All Rights Reserved.
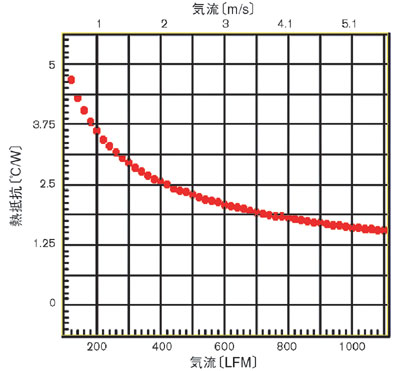 図7 気流による熱抵抗の変化 フィン付きのアルミニウム製ヒートシンクの熱抵抗は、気流(空冷)により大きく変化する(提供:米Aavid Thermalloy社)。
図7 気流による熱抵抗の変化 フィン付きのアルミニウム製ヒートシンクの熱抵抗は、気流(空冷)により大きく変化する(提供:米Aavid Thermalloy社)。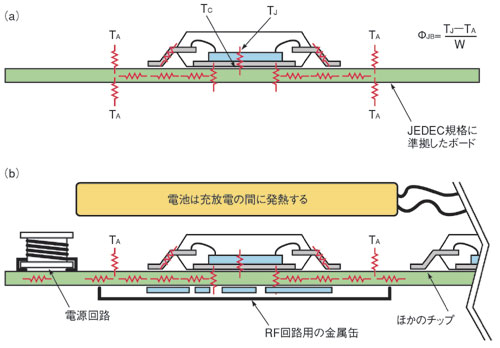 図8 プリント基板/部品と熱の関係 ФJBは、部品がJEDEC規格に準拠したプリント基板上にある場合の接合部から外部への熱抵抗を表す(a)。電池、電源回路、RF回路用の金属缶、ほかのチップなどを加えると、ICはさらに加熱される(b)。
図8 プリント基板/部品と熱の関係 ФJBは、部品がJEDEC規格に準拠したプリント基板上にある場合の接合部から外部への熱抵抗を表す(a)。電池、電源回路、RF回路用の金属缶、ほかのチップなどを加えると、ICはさらに加熱される(b)。 図9 パソコン筐体における熱シミュレーションの結果 有限要素解析ソフトウエアでは、内部部品が生成する熱と、気流により除去される熱の両方をモデル化することができる(提供:Flomerics社)。
図9 パソコン筐体における熱シミュレーションの結果 有限要素解析ソフトウエアでは、内部部品が生成する熱と、気流により除去される熱の両方をモデル化することができる(提供:Flomerics社)。